Thin Films and Coatings
- Mapping water uptake in organic coatings – Paper
- Characterise multilayer films with IR spectroscopy at sub-micron resolution – Article – O-PTIR
- Chemical analysis of coatings with Raman spectroscopy – details
- Correlated chemical and mechanical information with combined Raman and nanoindentation – more info
- Surface adhesion property mapping at the nanoscale with AFM and Bruker Ringing Mode eg to investigate the properties of surface coating molecules – more details…
- Elemental analysis of layers and coatings
- Bruker M1 ORA Micro-XRF
- Brochure: Layer Analysis with Micro-XRF
- Application note: Analysing thin layers under vacuum
- Application note: Analysing jewellery alloys
- See lots of example images in our micro-XRF ebook
XRD
XRD (X-Ray Diffraction) provide non-destructive characterisation of thin layer structured samples. The Bruker D8 DISCOVER and DIFFRAC.SUITE software make it easier to perform common XRD tasks in thin film analysis:
- Grazing Incidence Diffraction (GID) for Surface sensitive Identification of crystalline phases and determination of their structural properties including crystallite size and strain.
- X-ray reflectometry (XRR) for thickness, material density and interface structures in multi-layer samples, from simple substrates to highly complex super-lattice structures.
- High-resolution X-Ray Diffraction (HRXRD) for epitaxial grown sample structures: layer thickness, strain, relaxation, mosaicity and composition analysis of mixed crystals.
- Stress and texture (preferred orientation) analysis
More about the Bruker D8 ADVANCE…
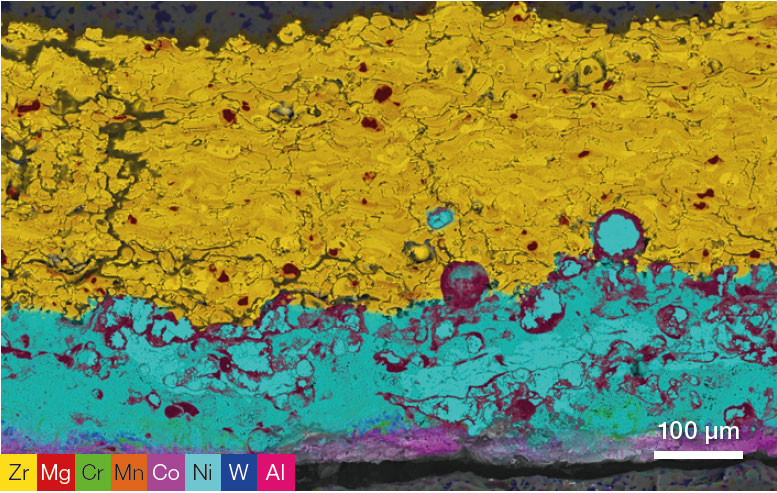
Example: Thermal Barrier Coating Failure Analysis
A case study of how SEM-EDS was used for failure analysis of thermal barrier coating in a turbojet engine, for materials development in aerospace engineering.

